Le SAINT-D va frapper dès 2024, et nous ne parlons pas de Didier Deschamps |
————— 18 Juin 2024 à 12h56 —— 21401 vues
Le SAINT-D va frapper dès 2024, et nous ne parlons pas de Didier Deschamps |
————— 18 Juin 2024 à 12h56 —— 21401 vues
Samsung SAINT n’est pas la marque de la nouvelle inclination religieuse de la marque coréenne, mais plutôt l’acronyme de Samsung Advanced Interconnect Technology, lequel désigne différentes techniques d’emballage 3D. Selon les informations du Korea Economic Daily (via Guru3D / TH.US), basées sur des « sources industrielles », l’entreprise va l’utiliser dans le courant de l’année avec la mémoire HBM (High Bandwidth Memory) – un type de mémoire pour laquelle la demande ne cesse de croître.

Le Saint-D officiel ; sa dentition a bien changé depuis © AFP
Comme l'explicite l’illustration ci-dessous, SAINT a trois branches distinctes. Les appellations sont suffisamment transparentes : SAINT-S concerne la SRAM, SAINT-L les dies logiques et SAINT-D la DRAM. La société travaille sur ces technologies depuis plusieurs années ; les premières annonces publiques relatives à celles-ci remontent à 2022. Et à l’évidence, l’application commerciale pour la SAINT-D doit débuter cette année.
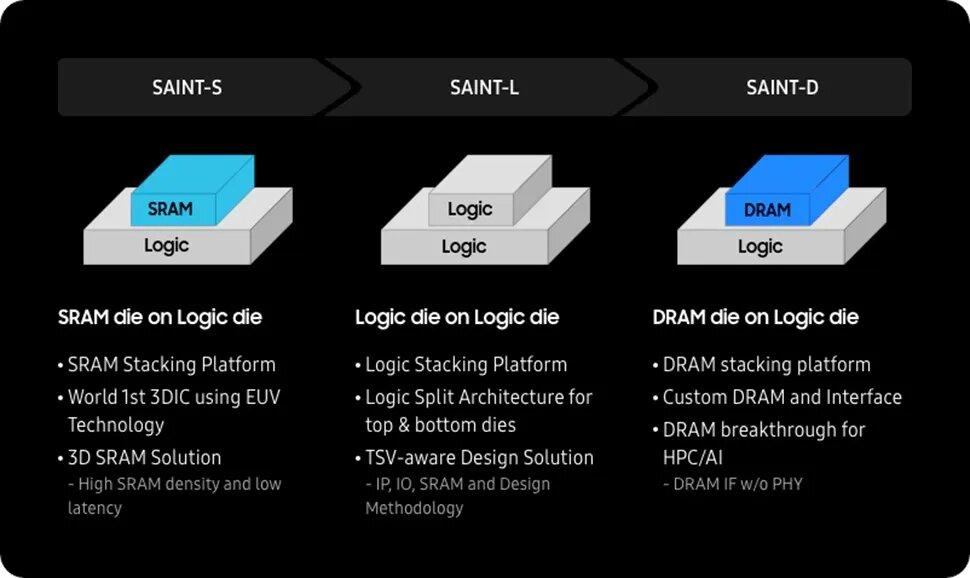
Concernant la méthode, là encore, les images sont suffisamment évocatrices. L’idée est d’empiler verticalement des puces de mémoire HBM sur des CPU ou GPU. Par rapport à la technologie 2,5D actuelle qui consiste à relier les puces HBM aux GPU ou CPU horizontalement par le biais d’un interposeur en silicium, cet empilement vertical élimine ce dernier de l’équation et aboutit à divers avantages pratiques, tels qu’une consommation d’énergie réduite, de meilleurs débits et une latence amoindrie ; au prix d’une fabrication plus complexe, donc plus onéreuse.
Comme le souligne l’article source, Samsung commercialisera ce conditionnement 3D HBM avancé sous la forme d'un service clé en main. Sa division "memory business" sera en charge de la production des puces HBM, tandis que la branche fonderie se chargera de la fabrication des processeurs à proprement parler commandés par les clients.
L’inconnue de cette histoire, ce sont les clients justement. Pour le moment, nous n’avons pas eu vent de puce conçue pour exploiter cette technique d’emballage 3D dès 2024. Le cas échéant, ils ne devraient pas tarder à se manifester.
Enfin, sachez qu’à terme – d’ici 2027 – Samsung envisage une technologie d'intégration hétérogène tout-en-un.
